Reliability Study of GaN-on-SiC HEMT RF Power Amplifiers
Keywords:
GaN-on SiC, HEMT, RF power amplifier, thermo-mechanical and electrical reliabilityAbstract
The RF power amplifier demonstrators containing each one GaN-on-SiC, HEMT, CHZ015A-QEG, from UMS in SMD quad-flat no-leads package (QFN) were subjected to thermal cycles (TC) and power cycles (PC) and evaluated electrically, thermally and structurally. Two types of solders, Sn63Pb36Ag2 and lead-free SnAgCu (SAC305), and two types of TIM materials, NanoTIM and TgonTM 805, for PCB attachment to the liquid cold plate were tested for thermo-mechanical reliability. Changes in the electrical performance of the devices, namely the reduction of the current saturation value, threshold voltage shift, increase of the leakage current and degradation of the HF performance were observed as a result of an accumulated current stress during PC. No significant changes in the investigated solder or TIM materials were observed.
References
U. K. Mishra, L. Shen, T. E. Kazior, and Y. F. Wu, “GaN-based RF power devices and amplifiers,” Proc. the IEEE, vol. 96, no. 2, pp. 287-305, February 2008.
H. Kim, V. Tilak, B. M. Green, J. A. Smart, W. J. Schaff, J. R. Shealy, and L. F. Eastman, “Reliability evaluation of high power AlGaN/GaN HEMTs on SiC substrate,” Physica Status Solidi (a), vol. 188, no. 1, pp. 203-206, November 2001.
Y. C. Chou, D. Leung, I. Smorchkova, M. Wojtowicz, R. Grunbacher, L. Callejo, Q. Kan, R. Lai, P. H. Liu, D. Eng, and A. Oki, “Degradation of AlGaN/GaN HEMTs under elevated temperature lifetesting,” Microelectronics Reliability, vol. 44, no. 7, pp. 1033-1038, July 2004.
E. Zanoni, G. Meneghesso, M. Meneghini, A. Stocco, F. Rampazzo, R. Silvestri, I. Rossetto, and N. Ronchi, “Electric-field and thermally-activated failure mechanisms of AlGaN/GaN high electron mobility transistors,” ECS Transactions, vol. 41, no. 8, pp. 237-249, 2011.
G. Meneghesso, M. Meneghini, D. Bisi, R. Silvestri, A. Zanandrea, O. Hilt, E. Bahat-Treidel, F. Brunner, A. Knauer, J. Wuerfl, and E. Zanoni, “GaN-based power HEMTs: parasitic, reliability and high field issues,” ECS Transactions, vol. 58, no. 4, pp. 187-198, 2013.
A. Barnes, ESCCON 2013, 12-14 March 2013, ESA/ESTEC, Holland.
F. B. McLean, H. E. Boesch, J. M. McGarrity, and R. B. Oswald, “Rapid annealing and charge injection in Al2O3 MIS capacitors,” IEEE Transactions on Nuclear Science, vol. 21, no. 6, pp. 47-55, December 1974.
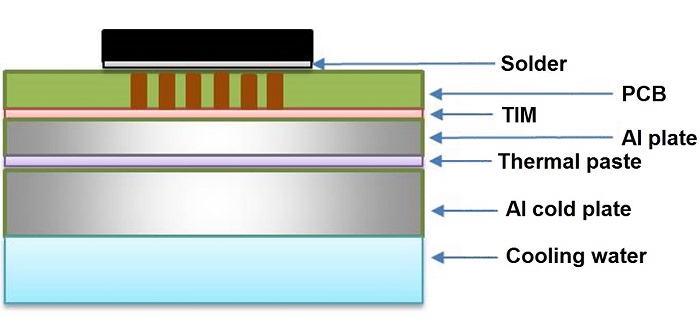
Published
How to Cite
Issue
Section
License
Submission of a manuscript implies: that the work described has not been published before that it is not under consideration for publication elsewhere; that if and when the manuscript is accepted for publication. Authors can retain copyright in their articles with no restrictions. is accepted for publication. Authors can retain copyright of their article with no restrictions.
Since Jan. 01, 2019, AITI will publish new articles with Creative Commons Attribution Non-Commercial License, under The Creative Commons Attribution Non-Commercial 4.0 International (CC BY-NC 4.0) License.
The Creative Commons Attribution Non-Commercial (CC-BY-NC) License permits use, distribution and reproduction in any medium, provided the original work is properly cited and is not used for commercial purposes.



